EUVの構造と原理
図1にEUV露光装置の構造と原理を示す。まず目を引くのは、その圧倒的な巨大さである。図中に示した人間との比較からも分かるように、EUV露光装置は、実際にはスクールバスほどの大きさを持つ。
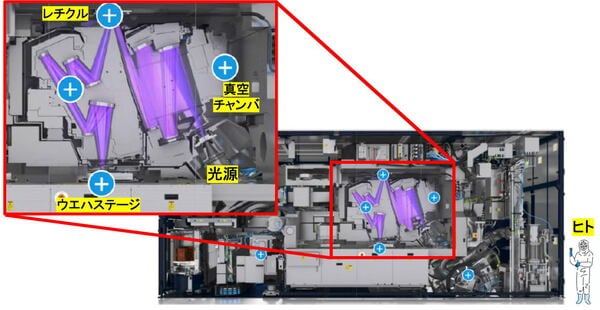 図1 EUV露光装置とその構造
図1 EUV露光装置とその構造出所:ASMLのHP(https://www.asml.com/en/products/euv-lithography-systems)に筆者加筆
拡大画像表示
次に、EUV露光の原理について説明する。光源から放射されるのは、波長13.5nmのEUV光である。この波長の光は空気中の酸素に強く吸収されるため、露光装置内部はすべて真空状態に保たれている。また、13.5nmのEUV光は通常のレンズを透過できない。そのため、光の集光や結像には、シリコン(Si)とモリブデン(Mo)を交互に積層した多層膜反射ミラーが用いられている。
このEUV光は、半導体回路パターンが描かれたレチクル(原版)に照射され、そこからの反射光がウエハステージ上に導かれる。そして、ウエハ表面に塗布された感光性レジストが露光され、回路パターンが転写される。
EUVの開発を極めて難しくしている要因は、すべての工程を真空チャンバ内で行わなければならない点に加え、非常に高い光源出力が要求される点にある。その理由は、EUV光が多層膜反射ミラーで反射されるたびに、光の強度が約70%にまで低下してしまうためである。図から分かるように、EUV光は露光プロセスの中でおよそ10回程度反射を繰り返す。その結果、最終的にウエハに到達する光の強度は、光源出力の3%以下にまで減少してしまう。
このため、EUV露光装置を量産機として成立させるには、光源出力として最低でも約250Wが必要とされてきた。しかし、このレベルの出力を安定して実現することは、当初は極めて困難であり、EUV実用化における最大の技術的障壁となっていた。
EUV量産機に到達するには「宇宙戦艦ヤマト」が必要?
波長13.5nmのEUV光を発生させるために採用されたのが、LPP(Laser Produced Plasma:レーザー生成プラズマ)方式である(図2)。